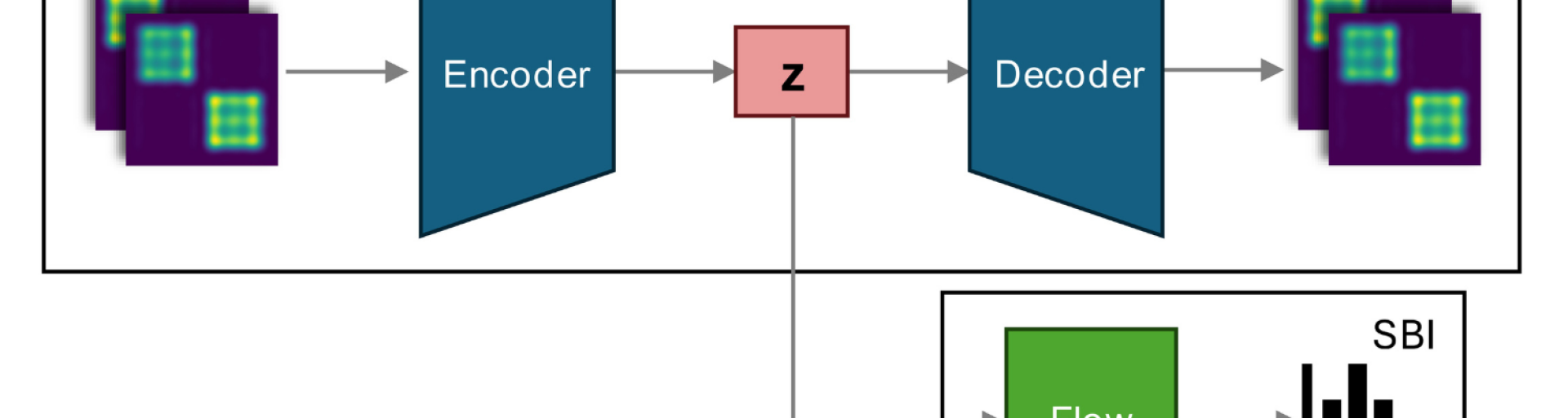
Simulation-based inference for imaging and wafer metrology
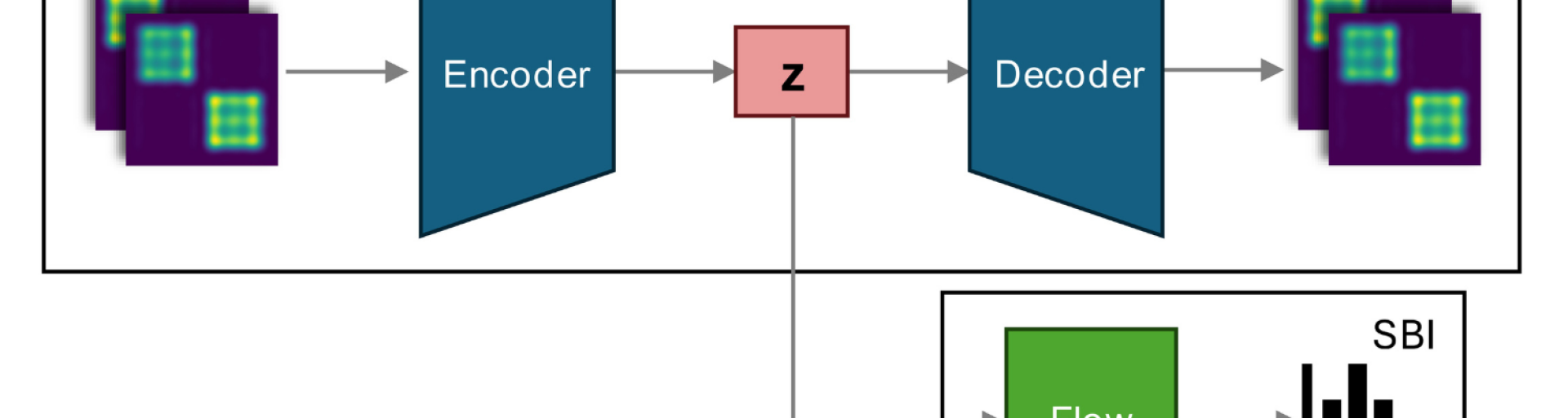
Who
The proposed project combines the strengths of three research groups focusing on Semiconductor imaging and metrology (L. Amitonova ARCNL), Machine Learning (P. Forré, UvA), and Computational Imaging (T. van Leeuwen, CWI).
How and What
The aim of this collaboration is to develop novel data-driven methods for imaging, uncertainty quantification, and experimental design in the context of semiconductor imaging and metrology. The project will build on earlier projects on simulation-based inference, computational imaging and compressive sensing. The particular focus of this project will be on accurate simulation of optical systems through data-driven modeling, uncertainty quantification in imaging and metrology through simulation-based inference, and experimental design of optical systems that optimize results for a given application.